
拆开世界上先进固态硬盘的外壳,映入眼帘的是一颗颗黑色小方块,它们是固态硬盘记录数据的媒介,也是半导体存储技术发展至巅峰的体现。自东芝发明闪存以来,闪存颗粒已有多种形态,当然最常见的有TSOP与BGA两种外在封装形式。
TSOP:
TSOP是“Thin Small Outline Package”的缩写,意思是薄型小尺寸封装。TSOP内存是在芯片的周围做出引脚,采用SMT技术(表面安装技术)直接附着在PCB板的表面,具备成本低、应用广的特点。

BGA:
BGA是TSOP之外的另一种封装形式,它的引脚存在于芯片底部,以球栅阵列的形式呈现,简称BGA(Ball Grid Array Package)。BGA能够在相同体积内封装更大容量的芯片,提升存储密度的同时降低了体积占用,广泛应用于移动设备UFS闪存以及M.2固态硬盘闪存颗粒当中。

封装起来的芯片:

闪存颗粒黑色的外表只是封装所用的树脂材料,而被封在内部的闪存芯片已经被自动化生产工具使用细微铜线与对应的外部接口相连,这个过程被称之为引线键合。

而在需要用多层堆叠的3D封装来提升存储密度时,还会应用到更加先进的TSV硅通孔技术。

芯片内部的堆叠:
闪存从2D到3D的转变不仅仅是向下图这样将多个闪存芯片直接堆砌起来。
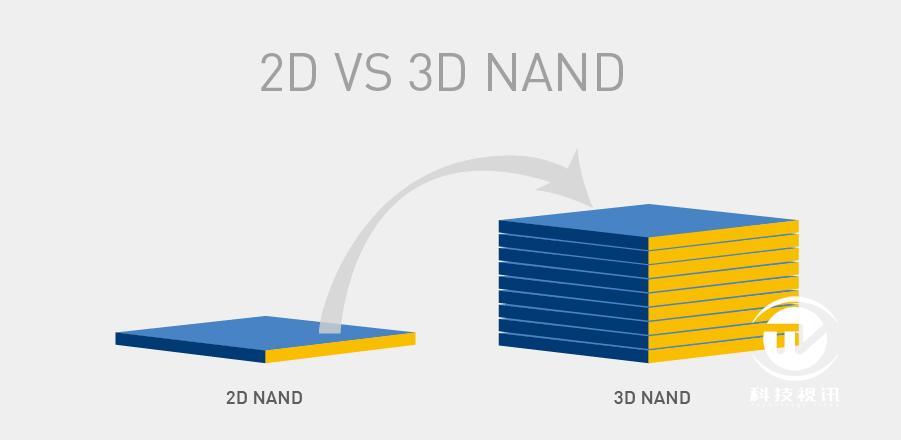
除了三维立体的变化,还涉及到了结构与工艺的改变。
东芝BiCS 3D闪存应用了全新的Charge Trap结构,相比传统Floating Gate闪存结构在抗读取干扰方面具备明显优势,从根本上提升了性能。
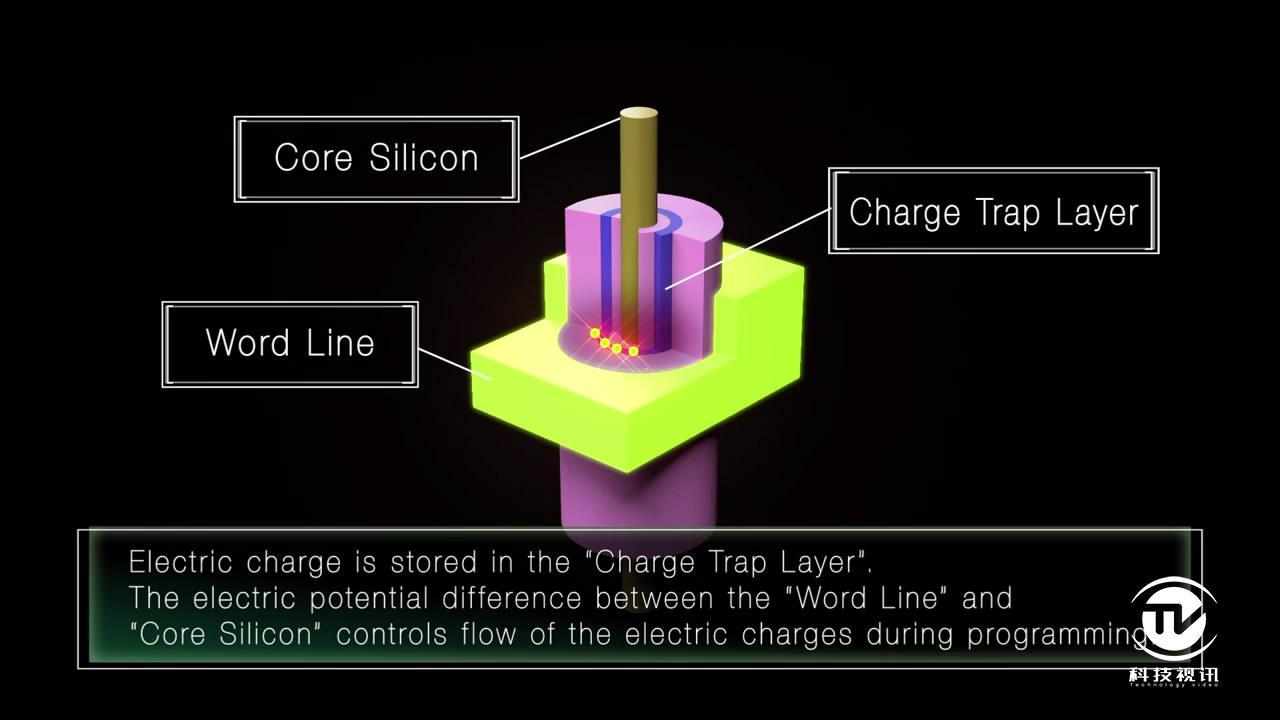
在2018年,东芝将继续提升3D闪存堆叠层数至96层,延续容量增长与成本降低趋势,使优秀技术真正造福于民。堆叠层数的提升不仅仅是数字的增长,更是一次次技术革新带来的进步。

关于Toshiba东芝:
1984年东芝发明Flash闪存,2007年首次3D闪存理论,将闪存单元从二维平面发展为3D立体结构。东芝第三代BiCS 3D闪存应用64层堆叠技术达成业界最高的单Die 512Gb存储密度。2017年东芝领先宣布QLC闪存商用计划,新闪存将于今年晚些时候面市。

